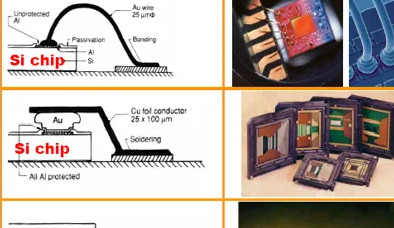
底部填充胶工艺技术是一种在电子制造行业中广泛应用的工艺技术,主要用于在芯片封装时填充芯片与基板之间的空隙,以增强芯片与基板之间的结合力和可靠性。
原理和作用
底部填充胶的基本原理是利用液态胶水填充芯片与基板之间的间隙,然后通过固化反应使胶水成为固态,以实现芯片与基板之间的牢固连接。这种工艺技术可以提高电子设备的可靠性,降低产品损坏的风险。
工艺流程
烘烤:确保主板干燥,防止填充后产生气泡。
预热:提高底部填充胶的流动性。
点胶:使用自动点胶设备将胶水注入芯片与基板之间的间隙。
固化:通过加热或其他方式使胶水固化,形成牢固的粘接层。
检验:确保填充效果符合要求。
应用场景
底部填充胶工艺技术广泛应用于各种电子制造领域,如手机、电脑、平板电脑、电视、音响等。在这些领域中,该技术的主要作用是提高电子设备的可靠性和稳定性,降低产品损坏的风险。
未来展望
随着科技的不断发展,底部填充胶工艺技术也在不断进步和完善。未来,这种技术将更多地应用在新能源汽车、物联网、人工智能等领域。同时,随着自动化和智能化制造的不断发展,底部填充胶工艺技术的自动化程度也将不断提高,从而进一步提高生产效率和产品质量。
立即注册即可免费试用绿建管家软件
立即注册